Optikai felületek deflektometriás vizsgálata
A méréstechnikában fontos szerepet tölt be az optikai felületek - különös tekintettel a reflektálók - vizsgálata. A reflektáló felületnek köszönhetően strukturált fényt tudunk alkalmazni, amely a felületre jellemző tulajdonságokat magába foglalva arról visszaverődik. Ezt a visszaverődő fényt egy detektor segítségével rögzíteni tudjuk. Ilyen strukturált fényt alkalmazó módszerekből sok különböző változatot ismer a szakirodalom. Ezen eljárások áttekintése során találkoztam a deflektometria jelenségével. A deflektometria egy új eljárás, amely komoly lehetőségeket rejt magában, és amely alkalmazása során periodikusan változó intenzitású képet képezünk le a vizsgálandó felülettel. Ezt a periodikusan változó struktúrát adott fázisértékkel többször eltoljuk [2], majd minden eltolásnál felvételt készítünk. Ezekből a felvételekből ismert matematikai módszerekkel [1] rekonstruálni tudjuk az eredeti felületet.
Dolgozatom célja egy olyan rendszer kialakítása, amellyel érintésmentesen tudunk vizsgálni optikai felületeket, valamint meg tudjuk határozni a felület sajátosságait. A dolgozat megírása előtt irodalomkutatást végeztem, amely során megvizsgáltam az optikai felületvizsgálat lehetőségeit. Az irodalomkutatás elvégzése után modelleztem a jelenséget, amely során több, a szakirodalomban megtalálható algoritmust is kipróbáltam. Ezek eredményeit összehasonlítottam. Ezután eltérő, valós felületeken végeztem méréseket. A mérési eredményeket a dolgozatban összefoglaltam és kiértékeltem.
Irodalom:
[1] Knauer M. C., Kaminski J., Hausler G.: Phase Measuring Deflectometry: a new approach to measure specular free-form surfaces, Proc. SPIE 5457, 2004., pp. 366-377.
[2] Stoilov G., Dragostinov T.: Phase-stepping Interferometry: Five-frame Algorithm with an Arbitrary Step, Optics and Lasers in Engineering 28, 1997., pp. 61-69.
[3] Morimoto Y., Masaya A., Fujigaki M., Asai D.: Shape Measurement by Phase-Stepping Method Using Multi-Line LEDs, Wakayama University, Japan, 2010.
[4] Szwedowicz K. K.: 3D-deflectometry: Fast nanotopography measurement for the semiconductor industry, Technische Universiteit Eindhoven, 2006.
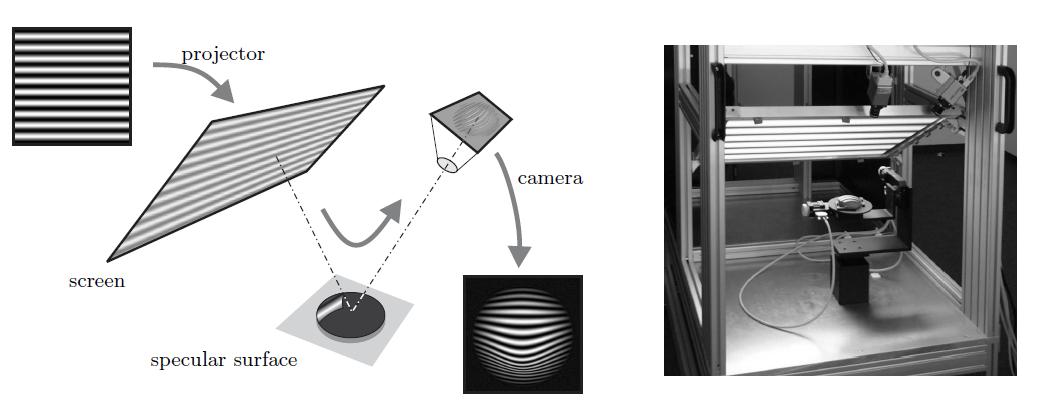
szerző
-
Nagy Vendel
mechatronikai mérnöki
nappali alapszak
konzulens
-
Dr. Antal Ákos
adjunktus, (külső)

